高電子移動度トランジスタによる高効率テラヘルツ
電磁波放射に関する研究
著者
細野 洋平
学位授与機関
Tohoku University
修士学位論文
高電子移動度トランジスタによる高効率テラヘルツ
電磁波放射に関する研究
東北大学大学院 工学研究科
電気・通信工学専攻
尾辻・末光研究室
博士課程前期2年
A6TM2058
細野 洋平
平成
20 年 2 月 20 日
目次
第1章 序論 1.1 研究の背景 1.2 研究の目的 1.3 本論文の構成 第2章 高電子移動度トランジスタにおけるプラズモン共鳴 2.1 高電子移動度トランジスタ 2.2.1 高電子移動度トランジスタの基本特性 2.2.2 電子走行型動作によるテラヘルツ帯動作 2.2 プラズモン共鳴効果の物理 2.2.1 高電子移動度トランジスタ内の二次元電子プラズマ 2.2.2 ソース端短絡/ドレイン端開放条件におけるプラズマ不安定性 2.2.3 プラズモン共鳴特性を決定するパラメータ 2.2.4 Ⅲ-Ⅴ族化合物トランジスタにおけるプラズモン共鳴特性 2.3.5 プラズモン共鳴動作によるテラヘルツ帯動作 第3章 高電子移動度トランジスタの試作 3.1 高電子移動度トランジスタのレイアウト設計 3.2 高電子移動度トランジスタの試作 3.3 高電子移動度トランジスタの評価 第4章 テラヘルツ帯高電子移動度トランジスタのテラヘルツ帯電磁波放射特性 4.1 テラヘルツ帯高電子移動度トランジスタ特性の評価 4.2 テラヘルツ帯高電子移動度トランジスタのテラヘルツ帯電磁波放射機構 4.3 テラヘルツ電磁波放射の実験 4.3.1 実験系 4.3.2 測定結果 4.4 考察第5章 結論 5.1 結論 5.2 今後の課題 謝辞 参考文献 研究業績 付録A: 高移動度トランジスタの作成
第1章
序論
1.1 研究の背景 近年、幅広い周波数における電磁波を用いて、我々の生活に必要不可欠な技術が数多く確立さ れている。電磁波とは一般的に3THz よりも低い周波数を「電波」、高い周波数を「光波」とい う。図1.1 にその電波と光波を用いての各周波数帯における応用開発例を示す。図で示されるよ うに、電波と光波の境を中心とする数百GHz~数十 THz の周波数領域(テラヘルツ帯)では応 用製品がほとんど見られない。テラヘルツ帯とは電波と光波の融合領域とも呼ばれている。これ はテラヘルツ帯電磁波(以下、テラヘルツ波)が電波の有する信号処理能力や透過性、光波の直 進性など、両者の長所とも言える特徴を有するためである。また、さらにテラヘルツ波は、水に 溶けやすい、気体に吸収されやすいといった、身近なものの振動周波数に合致するという特徴を も持つ。これらの特徴より、テラヘルツ波の応用技術として、イメージング技術、超高速通信シ ステムの構築、また医療用生体計測システム等[1-4]、幅広く挙げることができる。これらを背景 として、近年、テラヘルツ帯は、現在使用することのできる周波数帯の枯渇化問題の解決、また 既存技術の飛躍的向上、新技術の可能性を持つ周波数帯として非常に期待されている。 今後、テラヘルツ帯の応用開発を行うためには、テラヘルツ波を発振/制御することのできる 光源デバイスが必要である。現在、多くのテラヘルツ光源が開発されている。共鳴トンネルダイ オード[5]や量子カスケードレーザー(QCL)[6]、TUNNET ダイオード[7]のようなCW(Continuous Wave:連続光)光源、パラメトリック発振器(THz-OPO)[8]のようなパルス光源等が挙げられ る。しかし、未だに小型集積化、周波数変調が可能であり、また室温で動作する光源デバイスは 見当たらない。幅広く産業応用をするにはそれらの条件は必要不可欠であると考えられる。そこ で小型集積化技術が確立された電界効果型トランジスタ(Field Effect Transistor:FET)が、 室温動作可能なテラヘルツ光源になり得る候補として期待されている。FMラジオ
電子レンジ
マイクロ波
ミリ波 サブミリ波
赤外線 可視光 紫外線 X線
周波数 300MHz 300GHz 30THz 300THz 300PHz
携帯電話
光通信
無線LAN
赤外線センサ
可視レーザ
殺虫器
レントゲン
THz帯
FMラジオ
電子レンジ
マイクロ波
ミリ波 サブミリ波
赤外線 可視光 紫外線 X線
周波数 300MHz 300GHz 30THz 300THz 300PHz
マイクロ波
ミリ波 サブミリ波
赤外線 可視光 紫外線 X線
マイクロ波
ミリ波 サブミリ波
赤外線 可視光 紫外線 X線
周波数 300MHz 300GHz 30THz 300THz 300PHz
携帯電話
光通信
無線LAN
赤外線センサ
可視レーザ
殺虫器
レントゲン
THz帯
図.1 各周波数帯における応用開発例FET は、ソース電極・ドレイン電極・ゲート電極という3端子を持つ電流制御素子である。 ソース・ドレイン間に形成される電子走行層(チャネル)を電子が走行することでドレイン電流 が流れる。FET においては、一般にゲートバイアスによってチャネル内の走行キャリア数を制御 し、ドレイン電流を制御する。これを FET のキャリア走行型動作と呼ぶ。ゲートバイアスの ON/OFF スイッチング周波数を上昇させると、ある周波数でドレイン電流の ON/OFF が不可能 になる。そのような FET の動作限界周波数を示す指標として、電流遮断周波数(電流利得が 1 を下回る周波数)がある。FET をベースとしたテラヘルツ光源を実現するためには、電流遮断周 波数をテラヘルツ帯周波数まで向上させればよい。電流遮断周波数は電子がソースからドレイン に到達するまでの時間により定まる。したがって、電流遮断周波数を向上させる最も簡便な手法 としては、ソース・ドレイン間距離を短くすること(短チャネル化)、もしくは電子のドリフト 速度を向上させることが挙げられる。そしてこれらの手法はこれまで一般的に実践されてきた[9]。 短チャネル化については、半導体加工プロセス技術の進歩により主に進められてきた[9-12]。また、 ドリフト速度の向上は、高電子移動度トランジスタ(High-Electron-Mobility Transistor: HEMT)の考案等デバイス構造の工夫、また、高い移動度を持つ InP 系材料や、高耐圧である GaN 系材料を用いる等、半導体材料の改良により主に進められてきた。高電子移動度トランジ スタ(HEMT)とは、半導体へテロ構造によって誘起された二次元電子ガスをチャネルとした電 界効果型トランジスタであり、非常に優れた電子輸送特性を有する。現在ではチャネル長が15nm のInP 系 HEMT を用いて、615GHz という高い fTを得ることができている[13]。しかし、さらに 微細化が進みfTがテラヘルツ帯に到達するかというと困難である。極短のチャネルを形成すると、 量子力学的トンネル効果やトランジスタ特有の短チャネル効果が顕著となり、テラヘルツ帯では スイッチング動作が困難となる[14]。そこで、FET をテラヘルツ帯で動作させるために、二次元 電子プラズモン共鳴という物理現象を用いる。 FET では、ゲート電極にバイアスを印加すると、ゲート電極直下に電子を誘引して、シート状 の二次元電子層が形成される。高濃度に凝縮された電子群は流体として振る舞い、電子粗密の波 を生じる。これを二次元電子プラズマと呼ぶ。1993 年には、Dyakonov と Shur によって、二次 元電子プラズマ波は、良好な電子輸送特性に加えて共振器構造両端の境界条件が整えば、直流電 流成分によって不安定性が誘発され、電子濃度とチャネル長により定まる特性周波数において共 鳴振動を誘起することが示された[15-17]。波数が量子化、すなわち、エネルギーが量子化されたと いう意味で、このプラズマをプラズモンと呼ぶ。Dyakonov と Shur は、この二次元電子プラズ モン共鳴において、サブミクロンゲート長の FET ではその共鳴周波数がテラヘルツ帯に到達す ること、またゲート電圧を制御することで共鳴周波数を変調することが可能であることを理論的 に予測した[15]。 このDyakonov と Shur による予測を契機として、理論・実験の両面からテラヘルツ波の検出 /発生の研究が活発化している[18-26]。二次元電子プラズモン共鳴現象を用いて2004 年には Knap らによって、60nm ゲートを有する InP 系 HEMT を用いて、極低温の条件下で広帯域でのテラ
ヘルツ波放射を確認している[22]。またDyakonova らよって、2006 年に 150nm ゲートを有する GaN 系 HEMT を用いて、室温条件下でのテラヘルツ波放射に成功している[23]。また、HEMT のテラヘルツ放射に関する理論解析[25]もされ、今後の発展が非常に期待されている。 1.2 研究の目的 本研究では、HEMT の高効率なテラヘルツ光源としての可能性を検証することを目的として、 HEMT の試作、ならびに、HEMT からのテラヘルツ波放射の観測実験を行う。 HEMT をテラヘルツ帯デバイスとして機能させるには、従来の電子走行型動作ではなく、 HEMT 内部で生じる二次元電子プラズモン共鳴現象を利用したプラズモン共鳴動作をさせる必 要がある。そのプラズモン共鳴動作を実現するためのHEMT の試作を行う。試作では、二次元 電 子 プ ラ ズ モ ン 共 鳴 の 発 現 に 有 効 な 材 料 系 と し て InP 系 へ テ ロ 接 合 材 料 (InAlAs/InGaAs/InAlAs)を用いる。また、プラズモン共鳴周波数がテラヘルツ帯に到達し、 かつ強い共鳴強度を得るために、サブミクロンゲートの形成を目標とする。 次に、サブミクロンゲートを有するInP-HEMT を用いて、テラヘルツ波放射の観測実験を行 う。プラズモン共鳴の励起手法としては、直流バイアス印可にともなうプラズモン不安定性を利 用し、良好な電子輸送特性に加えて共振器構造両端の境界条件を整える。そして特定のバイアス 条件で共鳴振動状態となった二次元電子プラズモンから生じるテラヘルツ波放射をフーリエ変 換赤外分光計(FTIR)を用いて測定する。また、その結果を用いて、テラヘルツ光源としての 可能性について考察を行う。 1.3 本論文の構成 第1章・序論では、本研究の背景と目的について述べる。 第2章では、HEMT の基本特性、プラズモン共鳴特性について述べており、テラヘルツ帯デ バイスとしての可能性を示す。 第3章では、テラヘルツ帯動作可能のHEMT 試作を行った結果について述べる。 第4章では、テラヘルツ帯動作可能なHEMT の基本特性測定と FTIR 測定法を用いてのテラ ヘルツ帯電磁波放射の観測実験について述べる。 第5章では、本研究のまとめを行い、また今後の目標と展望について述べる。
第2章
高電子移動度トランジスタにおけるプラズモン共鳴効果
2.1 高電子移動度トランジスタ 2.1.1 高電子電子移動度トランジスタの原理 始めにHEMT の断面構造を図 2.1 に示す。ゲート電極直下にはバリア層、チャネル層、バッ ファ層が半絶縁性基板上に形成されている。バリア層はショットキー障壁形成のための非ドープ 層、n 型ドープしたキャリア供給層と、キャリア電子のイオン化不純物散乱を低減するために設 けられた非ドープのスペーサ層によって形成されている。また、ソース・ドレイン電極直下には オーミック接触のため、n 型ドープされたキャップ層が設けてある。ヘテロ材料を積層したヘテ ロ接合によって、チャネル層にキャリアを閉じ込め、二次元電子層を形成する。また、変調ドー ピングによって、チャネル層の二次元電子濃度を制御可能としており、トランジスタ動作を可能 とする。このことについて定量的に説明する。 ゲート直下における伝導体のエネルギーバンド図の様子を図2.2 に示す。図 2.2(a)は HEMT がON 状態、図 2.2(b)は OFF 状態のエネルギーバンド図である。ゲート直下は、ゲート電極 とチャネル層でバリア層を挟み込んだ平行平板キャパシタと見ることができる。よって、ゲート 直下における電荷量は、(
)
d
d
d
d
V
V
qn
S D B th gs S+
+
+
Δ
−
=
ε
(2.1) となる。このとき、各パラメータは以下の通りである。 q:キャリア素量,ns:キャリア電子の面密度,Vgs:ゲート電圧,Vth:閾値電圧, ε:バリア層の誘電率,dB:ショットキー障壁層の厚さ,dD:キャリア供給層の厚さ, dS:スペーサ層の厚さ,Δd:キャリア電子のヘテロ界面からの実効的距離 よって、二次元電子密度はゲート電圧Vgsによって変化することができる。電荷量がゼロとなる、 すなわちピンチオフ状態となるときのVgsが閾値電圧 Vthである。このときのエネルギーバンド は図2(b)に示すようにフェルミ順位EFがチャネルの伝導体底と一致し、 22
D D B D D C B thN
d
q
d
d
N
q
E
V
ε
ε
φ
−
Δ
−
−
=
(2.2) となる。各パラメータは以下の通りである。ΦB:ゲートのショットキー障壁高さ ΔEC:バリア層・チャネル層間の伝導体エネルギー差,ND:ドナー濃度 (2.1)式を用いて、ソース・ドレイン間のチャネル層に流れる電流 Idsが次の式で与えられる。 ch d s ds
en
v
W
I
=
(2.3) Wchはチャネル幅、vdはキャリア電子のドリフト速度である。上式より、Vgsによりチャネル内の 走行キャリア数を制御し、Idsを制御できることが分かる。 なお、閾値電圧の正負は大きな意味を持つ。n 型 HEMT の場合、閾値が負であれば、Vgsがゼ ロの時にチャネルはオンとなり、同じく正であればチャネルはオフとなるからである。閾値が負 の場合、ゲートに負の電圧を印加してキャリアを空乏化させることによってピンチオフさせる。 これをデプレッション型HEMT という。一方、閾値が正であれば、Vgsがゼロの時にチャネルは オフとなり、ゲートに正電圧を印加してキャリアを増加させることによってオンとなる。これを エンハンスメント型HEMT という。 S.I. substrate Drain Source Gateチャネル層
バッファ層
バリア層
Etch stopキャップ層
ショットキー障壁 : 非ドープ層 キャリア供給層 スペーサ層 S.I. substrate Drain Source Gateチャネル層
バッファ層
バリア層
Etch stopキャップ層
ショットキー障壁 : 非ドープ層 キャリア供給層 スペーサ層 図2.1 HEMT の基本構造 gs qVGate
FE
高電子濃度 CE
B φ B φ dD dS C E Δ gs qVGate
FE
高電子濃度 CE
B φ B φ dD dS C E Δ th V qGate
FE
CE
B φ B φ dD dS C E Δ th V qGate
FE
CE
B φ B φ dD dS C E Δ (a)ON 状態 Vgs>Vth (b)OFF 状態 Vgs=Vth 図2.2 HEMT のエネルギーバンド図Vgsを変化させたとき、どれほどドレイン-ソース電圧 Vdsを変化することができるかを示す指 標として真性相互コンダクタンス:gmiがあり、
⎟⎟
⎠
⎞
⎜⎜
⎝
⎛
Δ
+
+
+
=
=
Δ
+
+
+
=
d
d
d
d
C
C
v
d
d
d
d
v
g
S D B d S D B s miε
ε
(2.4) で表すことができる。Cはゲート容量と呼ぶ。実際には素子の内部抵抗による電圧降下の影響で、 素子の外部に取り出せる相互コンダクタンスgmは、gmiより小さくなり、 S mi mi mR
g
g
g
+
=
1
(2.5) となる。ここで、RSはソース抵抗である。式(2.3)(2.4)より、gmを向上させるには、ゲート・ チャネル間距離を小さくすることが必要とされる。ここで、先に示したゲート直下における電荷 量は、平行平板キャパシタを仮定して導出している。これより、この距離とゲート長との大きさ 比:アスペクト比も重要となる。電極の大きさが間隔と比較して十分に大きくしないと、電極端 における電気力線の広がりが無視できなくなるためである。実際、ゲート・チャネル間距離を一 定にして、ゲート長を小さくしていくと、Vthが負の方向にシフトし、gmが低下する現象が見ら れる。これを短チャネル効果という。 トランジスタの動作速度を表す指標のひとつとして一般的なのが電流利得遮断周波数:fTと最 大発振周波数fmaxがあり、近似的には以下のように与えることができる。 gs m TC
g
f
π
2
≈
(2.6) gd g TC
R
f
f
π
8
max≈
(2.7) Cgsはゲート-ソース間寄生容量、Cgdはゲート-ドレイン間寄生容量、Rgはゲート抵抗である。fT は電子の走行時間効果と入力端の寄生容量によって律速されており、スイッチング動作とよく対 応する。一方、fmaxは帰還容量を介した効果がfTに加味された形をとることから、増幅器として の利得帯域とよく対応する。fTについてはトランジスタの遅延時間τを用いると、 s Tf
πτ
2
1
=
(2.8) と表すことができる。この遅延時間τはゲート長に比例する成分とそうでない成分とで分けるこ とが出来る。前者を真性遅延時間、後者を寄生遅延時間:τexという。これを考慮してτはゲート長:Lgを含め、 ex d g s
v
L
τ
τ
=
+
(2.9) と表すことができる。よって、HEMT の高速化を図るには、ゲート長を短縮すること、移動度 の高い材料を選択すること、また寄生遅延時間を削減することが挙げられる。 高移動度を持つ材料の選択については、高い移動度とキャリア密度が実現することのできる InP 基板上の InAlAs/InGaAs ヘテロ接合を用いた InP-HEMT が積極的に用いられている。また、 同じ材料でも組成比によってさらに移動度を高めることができる。各材料系における二次元電子 の室温移動度を表2-1 に示す[10,26]。さらに高い移動度を狙ってInAs や InSb をチャネル層に用 いたHEMT も検討されているが、これらの材料はバンドギャップが小さく耐圧が取れないため、 動作可能範囲が低電圧に限られている。現在ではInP 系 HEMT が最も優れた高周波特性を得る ことのできる材料であり、また注目されている。 寄生遅延時間については、その要因としてゲート電極からの電気力線が横方向に広がることに よって生じる実効ゲート長の広がりや、ソース・ドレインの寄生抵抗と寄生容量によって生じる 充電時間がある。短ゲートにおいては特に、真性遅延時間と比較して寄生遅延時間が大きくなる ため、超高速化を試みるには寄生遅延時間をいかに削減するかが重要となる。 表2-1 各材料系における二次元電子の室温移動度 ヘテロ構造 基板材料 室温移動度 〔cm2/Vs〕 AlGaAs/GaAs GaAs 5000 AlGaAs/In0.25Ga0.75As GaAs 6000~7000 InAlAs/In0.53Ga0.47As InP 8000~10000 InAlAs/In0.8Ga0.2As InP 12800 InAs/AlSb GaAs 20700 2.1.2 高電子移動度トランジスタのテラヘルツ帯動作 前項では、HEMT の電子走行型デバイスとしての動作について示した。それらをまとめて、 図2.3 に電子走行型動作におけるパラメータ相関図を示す。実効長 L を短くすることで、fT、fmax とgmは向上、つまり性能が向上することになる。一方で、寄生容量Cgs、Cdsと寄生抵抗Rmgは、 fT、fmaxの律速因子として寄与することになる。現在の微細化によるfTの向上を図2.4 に示す。図中では InP-HEMT と GaAs-HEMT の性能評 価を行っている。表 2-1 でも示したように、InP 系材料は高い移動度を有するために、 GaAs-HEMT と比較して高速化に優れている。現在では、チャネル長が 15nm の InP 系 HEMT を用いて、615GHz という高い fTを得ることができている[13]。今後も微細化が進み、キャリア走 行型デバイスとしてテラヘルツ帯に到達する可能性も秘めているが、高いテラヘルツ帯での動作 は困難と思われる。そこで、HEMT の電子走行型動作の他に、二次元電子プラズモン共鳴現象 を利用したプラズモン共鳴動作に注目する。このプラズモン共鳴動作を用いることで、HEMT を幅広いテラヘルツ帯で動作させることができると考えられている。次節においては、その二次 元電子プラズモン共鳴現象について記す。 図2.3 電子走行型動作におけるスケーリング 図2.4 HEMT の高速化
2.2 プラズモン共鳴効果の物理 2.2.1 高移動度トランジスタ内の二次元電子プラズマ 図2.5 に HEMT 内に生じるプラズモン共鳴の模式図を示す。Vgsは実効ゲートバイアス、L は チャネル長、Vdsは直流ソース・ドレイン間電圧である。HEMT の電子走行層(チャネル層)は 高濃度の電子群が存在している。高濃度に凝縮された電子群は流体として振るまう。このような 状態となった電子群は、プラズマ流体として考えることができる。このプラズマ流体は、理想的 には電荷はシート状に分布するため、二次元電子プラズマと呼ばれている。二次元電子プラズマ が存在しているという条件下、ソース・ドレイン間に直流バイアス Vdsを印加すると、電荷に偏 りが生じる、つまりプラズマが振動し、位相を持った波が伝わるようになる。この波を二次元電 子プラズマ波という。水の流れの上に波が立ち、それが伝播するように、電子流体のドリフト流 上をプラズマ波が伝播する。ソース・ドレイン間で共振器長を満足すると、このプラズマは定在 波として存在し、これをプラズマ共鳴状態と呼び、その周波数をプラズモン共鳴周波数という。 波数が量子化された、すなわちエネルギーが量子化されたという意味で、この状態のプラズマ波 プラズモンと呼ぶ。例として、奇数定在波が生じた場合の模式図を図2.6 に示す。 つまりは、ソース・ドレイン間に直流バイアスを印加することでプラズモン共鳴が励起される。 このプラズモン共鳴振動を信号源として利用することで、テラヘルツ波の放出を行うことができ る。以降、チャネル内でプラズモン共鳴を励起させた場合のトランジスタ動作を、通常のキャリ ア走行型動作と区別する意味で、プラズモン共鳴動作と呼ぶことにする。
ドレイン
ソース
ゲート
gU
gsV
L
二次元電子 プラズマドレイン
ドレイン
ソース
ソース
ゲート
gU
gsV
L
二次元電子 プラズマ 図2.5: FET 上でのプラズモン共鳴動作図2.6: プラズモン共鳴状態 2.2.2 ソース端短絡/ドレイン端開放条件におけるプラズマ不安定性 ゲート・チャネル間距離がチャネル長L に比べて十分に短い場合、チャネル長方向(ソース・ ドレイン方向:x 方向)の電界はチャネル厚さ方向(ゲート・チャネル方向:z 方向)と比較する と、十分に緩やかである。つまり、チャネル長方向(x 方向)の電界は考慮せず、チャネル厚さ 方向(z 方向)のみの電界を考慮するというグラジュアル・チャネル近似を用いることができる。 そのような条件下では、チャネルのゲート接合面における2次元電子濃度nsは
ed
x
U
e
x
CU
n
s=
(
)
=
ε
(
)
(2.10) と表すことができる。C はゲート・チャネル間容量、U(x)は実効ゲート・チャネル間電位差、d はゲート・チャネル間距離である。HEMT チャネル中の2次元電子濃度 nsが1011~1012 cm-2程 度になると、平均電子間距離(約10 nm)は電子の平均自由行程を大幅に下回る。これは、電子 同士が常に衝突し合っているような状態である。すると、電子群はプラズマ流体としての性質を 示し始め、流体力学方程式による挙動の記述が可能になる。通常、チャネル厚はチャネル長・チ ャネル幅と比較すると十分に小さな値をとるため、電子プラズマはチャネル長・チャネル幅方向 のみの次元を有する2次元電子プラズマとして考えることができる。 2次元電子流体についてチャネル長方向(x 方向)の1次元運動方程式を立てると、⎟
⎠
⎞
⎜
⎝
⎛
∂
∂
+
∂
∂
=
=
−
∂
∂
−
x
v
v
t
v
m
dt
dv
m
v
m
x
x
U
e
e e eτ
)
(
(Euler の方程式) (2.11)0
)
)
(
(
)
(
=
∂
∂
+
∂
∂
x
v
x
U
t
x
U
(連続の方程式) (2.12)と表すことができる。meは電子有効質量、v は電子速度、 τ は運動量緩和時間である。(2.11)式 のmev/τ の項は、粘性による摩擦(フォノン散乱、不純物散乱、電子間散乱等)を表す。 次に HEMT がソース端短絡/ドレイン端開放条件に設定され、一定のドレインバイアス電流 (一定の電子ドリフト速度v0)、並びにゲートバイアス電圧U0のみが与えられている状態を考え る。まず、(2.11)、(2.12)式の解として以下の線形結合解を仮定する。
)
exp(
1i
t
v
v
v
=
d+
−
ω
(2.13))
exp(
1 0U
i
t
U
U
=
+
−
ω
(2.14) v は電子の局所ドリフト速度、U はチャネル内の局所ポテンシャルである。ソース端短絡/ドレ イン端開放条件を考慮すると、ソース端(x = 0)、ドレイン端(x = L)において 0)
0
(
x
U
U
=
=
(2.15)(
(
)
(
)
0
)
0
)
(
x
=
L
=
U
0v
1x
=
L
+
v
U
1x
=
L
=
j
d (2.16) という境界条件が与えられる。j は電流密度である。(2.13)、(2.14)式を(2.11)、(2.12)式に代入し、 (2.15)、(2.16)式の境界条件を適用するとω は次のように表すことができる。(計算の簡単化のた め、τ = ∞とする)
ω
ω
ω
=
′
+
′′
(2.17)Ls
v
s
d2
2 2−
=
′
ω
, d d dv
s
v
s
Ls
v
s
−
+
−
=
′′
ln
2
2 2ω
(2.18) , (2.19) ここで、ω’ はω の実部、ω” はω の虚部、s はε
e s em
d
n
e
m
eU
s
2 0=
=
(2.20) で与えられるプラズマ波速度である。 図2.7 は、チャネルにおけるプラズマ波伝播を示した模式図である。ドリフト速度 vdでドレイ ン方向へ流れる電子流体上を、波速s のプラズマ波が伝播している様子を示している。プラズマ 波の進行成分、ドレイン端における反射後の後退成分をそれぞれ電流jforward(ω)、jbackward(ω)とする と次のように表すことができる。)
)(
(
)
(
forward d forwarde
n
s
v
j
ω
=
Δ
ω
+
(2.21))
)(
(
)
(
backward d backwarde
n
s
v
j
ω
=
Δ
ω
−
(2.22)Δnforward、Δnbackwardはそれぞれ進行波、後退波の電子濃度振幅であり、プラズマ波振幅に相当する。 ドレイン端における反射前後で電流量は保存されるため、ドレイン端における振幅反射係数: Δnbackward /Δnforwardは次のように表すことができる。 d d forward backward
v
s
v
s
n
n
−
+
=
Δ
Δ
(2.23) ソース端(短絡(固定端):反射係数 = -1)、ドレイン端(開放:反射係数 = (s+v0)/(s-v0)) における反射係数を考慮して、時間t の間に得られる多重反射によるドレイン端でのトータルの 重畳波成分を求めてみる。往復の伝搬時間をTcycle、プラズマ波振幅の初期値をfinitとすると、 t i t init t i i init t i init t i T t d d inits
v
e
f
e
f
e
f
e
e
v
s
f
cycle ω ω ω ω ω ω′ − − ′+ ′′ ′′ − ′ −≡
⋅
≡
⋅
≡
⋅
⋅
⎟
⎟
⎠
⎞
⎜
⎜
⎝
⎛
⎟⎟
⎠
⎞
⎜⎜
⎝
⎛
−
+
( ) / (2.24) となる。s と v0の大小関係によって波の増幅(不安定)/減衰(安定)が定まることがわかる。 いま、増幅(不安定)/減衰(安定)を決定するω”をノンディメンジョンの不安定指数δとして 再定義し、s と v0の大小関係を示すパラメータとしてマッハ数Mp = v0/s を導入すると、不安定性 が生じる条件は(2.19)式を用いて以下のように表現できる。0
1
1
ln
)
1
(
2
2>
−
+
−
=
′′
≡
p p pM
M
M
Ls
ω
δ
(2.25) 不安定指数δ をマッハ数Mpに対しプロットしたものを図2.8 に示す。図より、波の増幅条件は、s
v
s
v
d<
d<
−
<
,
0
(2.26) となる。通常、HEMT のチャネル層中の電子ドリフト速度は 107 cm/s 程度、プラズマ波速度は 108 cm/s 程度であるため、(2.19)式の第一式は容易に実現できる。第二式はソース・ドレイン境 界条件を反転した場合に相当する。この場合は、|vd|> s である必要があり、成立は困難である。 以上から、ソース端短絡/ドレイン端開放の条件下では、プラズマ不安定性がプラズマ波、そ してプラズモン共鳴の増幅現象をもたらすことがわかる。これをプラズモンの自励発振と呼ぶ。 ただし、外力による摩擦((2.11)式の散乱項 mev / τ)により一方的な無限増幅とはならないこと に注意する必要がある。 また、ソース端短絡(反射係数 = -1)/ドレイン端短絡(反射係数 = -1)条件、ソース端 開放(反射係数 = (s-vd)/(s+vd))/ドレイン端開放(反射係数 = (s+vd)/(s-vd))条件といった 対称境界条件下では反射係数が1 以上になることはない。従って、共鳴振動を生じうる可能性は あるが、共鳴発振を得ることは困難になる。図2.7: チャネルにおけるプラズマ波挙動 図2.8: 不安定指数δ のマッハ数Mp依存性 2.2.3 プラズモン共鳴特性を決定するパラメータ プラズマ波は、ドリフトによる電子流に乗り伝播する。よって、この電子流が格子振動による フォノン散乱等を受けると、プラズマ波のコヒーレンス(位相連続性)が維持できなくなる。つ まり、チャネルを走行中の電子は平均1回程度の原子との衝突も許されない。この条件を式で表 現すると、以下のようになる。
L
L
m
U
e
L
U
v
L
e MFP=
⋅
=
⋅
=
>
0 2 0 0τ
τ
μ
τ
(2.27) ここで、LMFPは平均自由行程(電子が原子に衝突し、次に原子と衝突するまでの平均距離)であ る。プラズマ波速度s を用いると、 (2.26)式は次のように書き換えることができる。L
L
s
L
MFP=
>
2 2τ
,=
>
1
L
s
Q
τ
(2.28),(2.29)この条件を、プラズマ波のコヒーレンス条件と呼ぶ。また(2.29)式はプラズモン共鳴周波数の共 鳴強度、つまりQ 値となる。プラズモン共鳴現象を利用した光源で高出力を得るためには、Q 値 が十分な値をとる必要がある。その値を決定するための、共鳴振動状態の条件は、ソース・ドレ イン間に誘起される定在波の生成条件で与えられる。2.2.2 で取り上げたソース端短絡/ドレイ ン端開放条件では、定在波はソース端が節、ドレイン端が腹となった場合に生じる。即ち、
l
L
4
=
λ
(l:自然数) (2.30) の条件が満たされなければならない。プラズマ波速度s、電子ドリフト速度 vdを用いると、プラ ズモン共鳴周波数fpは次の式で与えられる。sL
v
s
l
f
d p4
)
)(
1
2
(
−
2−
2=
(非対称境界条件における共鳴周波数) (2.31) 一方、ソース端短絡/ドレイン端短絡条件、あるいはソース(側)開放/ドレイン(側)開放条 件等の対称境界条件においても定在波は生じうる。その場合、l
L
2
=
λ
(l:自然数) (2.32) となり、プラズモン共鳴周波数fpは次の式で与えられる。sL
v
s
l
f
d p2
)
(
2−
2=
(対称境界条件における共鳴周波数) (2.33) 以上より、s >> v0の条件では共鳴強度はコヒーレンス条件(2.27)式より sτ/L によって定まり、 共鳴周波数は定在波生成条件(2.31)式、あるいは(2.33)式よりL
s
f
p=
(2.34) によって定まることがわかる。2.2.4 Ⅲ-Ⅴ族化合物トランジスタにおけるプラズモン共鳴特性
前節では、共鳴強度sτ/L、共鳴周波数 s/4L がプラズモン共鳴特性を決定付ける重要なパラメー
タであることを述べた。図2.9 に、Ⅲ-Ⅴ族化合物トランジスタとして代表的な GaAs MESFET (MEtal Semiconductor FET)、InGaAs HEMT(High-Electron-Mobility Transistor)の性能 を、Si-MOSFET(Metal Oxide Semiconductor FET)と比較して示す[4]。図2.9(a)にはゲート 長-基本共鳴周波数f1=s/4L 特性を、(b)にはゲート長-共鳴強度指数 Q=sτ/L 特性を示す。図 2.9 (a)は(b)を算出する際に使用された物理パラメータを用いた。チャネルが InGaAs のような 混晶半導体材料で形成されている場合、混晶の度合い(この場合In と Ga の含有比率)によって、 電子有効質量me(= mr×m0)の値が異なる。なお、m0は静止電子質量、mrはm0を基準とした比電 子有効質量である。また、表2-2 で示したように、材料と組成比の違いによっても電子の移動度 は異なる。本研究の測定対象であるInP-HEMT に関しては、mr = 0.042、μ=1.2 m2/Vsec、Vg = 1.0V という値を使用した。
図2.9 から、Si MOSFET では有意な強度を得ることは出来ない。一方、InP-HEMT と GaAs MESFET では L の減少とともに共鳴周波数、Q 値ともに単調に増加することが確認できる。GaAs MESFET に関してはゲート長 Lg < 0.35 μm、InP-HEMT に関しては Lg < 0.5 μm で、有意な強 度(Q > 1)を得ることがわかる。一般的には、Ⅲ-Ⅴ族化合物半導体をチャネルに用いた FET は、優れた輸送特性を持つことから、プラズモン共鳴の励起対象として適していると言える。そ の中でも、本研究で取り扱うInP-HEMT は短ゲートで高い共鳴周波数と Q 値を得ることができ るため、プラズモン共鳴を励起するには非常に適したデバイスと言える。 プラズモン共鳴とは電子濃度振幅であり、つまり電流の局所的変化と言える。電流がテラヘル ツ帯周波数で振動すると、Maxwell の方程式より、その振動周波数の電磁波が放射される。つま り、InP-HEMT はプラズモン共鳴動作させることで光源として期待することができる。本研究 では、テラヘルツ波放射が可能な InP-HEMT の試作、またそのデバイスを用いてのテラヘルツ 波観測を目標としている。次章より、InP-HEMT の試作について議論する。その試作では、プ ラズモン共鳴周波数とQ 値が十分な値を取り、有意なテラヘルツ波放射が期待される 0.1μm 級 ゲートを有するInP-HEMT の作成を目標とした。
(a) 基本共鳴周波数
(b) 共鳴強度指数 Q 値
2.2.5 プラズモン共鳴動作によるテラヘルツ帯動作 前項までに二次元電子プラズモン共鳴の物理について記した。それらをまとめて、図 2.10 に プラズモン共鳴型におけるパラメータ相関図を示す。以下に、電子走行型動作とのスケーリング による物理の違いを記す。 図2.11 において、InP-HEMT を用いて電子走行型動作とプラズモン共鳴動作をさせた場合の 動作周波数領域を比較する。共に、ゲート長が短くなるに従い動作周波数は向上する。ここで (2.34)式より、プラズモン共鳴周波数は共振器長Lとプラズマ波速度s によって決定される。つ まり、L を決定すると、可動領域はsによることになる。 (2.20)式に示すように、sは Vgによ る電子濃度nsの平方根乗で表すことができるが、nsは10-10~10-12程度で制御できる。これより sの取り得る値も限定され、共鳴周波数もある帯域でのみ変調可能となる。よって、プラズモン 共鳴動作を行う際には、動作帯域に見合うLを選択する必要がある。 Cgs、CdsとRgの寄生成分は、電子走行型動作とは違い、動作を律速する要因にはならない。2.2.2 で記したように、ドレイン端開放/ソース端短絡の境界条件に合うようにCgs、Cdsが値を取ると プラズマ不安定性を誘起し、共鳴強度を増大することになる。また、Rg の寄生抵抗が高いほど、 放射強度が増すという報告がされている。 よって、プラズモン共鳴動作と電子走行型動作でのスケーリングは、以上の違いを考慮して行 う必要がある。
図2.10 プラズモン共鳴型動作を行う際のスケーリング
第
3 章
高電子移動度トランジスタの試作
3.1 高電子移動度トランジスタのレイアウト設計 前章においてテラヘルツ帯で動作するトランジスタについて示した。それをもとに、HEMT の試作を行う。レイアウトの作成にはJEDAT 社のα-SX を用いた。 図3.1 に1チップの HEMT レイアウト全面図を示す。1チップは 4.0mm 角としている。チッ プの下にはRF 用 HEMT が、右上には DC 用 HEMT を設計した。RF 用 HEMT の拡大図を図 3.2 に示す。HEMT の特性を評価するために、ゲート長 Lg は前章にて目標に定めた 100nm か ら250nm までの四水準、ゲート幅 Wg も 10μm から 50μm までの四水準をとるように設計され ている。図3.2 RF 用 HEMT 設計図(拡大図) 図中における MESA 等の単語は、各部分を形成するのに用いたマスクレイアウトの名前であ る。マスクの全体図を図3.4 に示す。HEMT の作成は主に四工程に分けることができ、それが図 に示すそれぞれのマスクによるものとなる。マスクパターンはMESA、ORMIC、GATE、PAD であり、図中で斜線となっている部分がそのマスクパターンに対応する(GATE は塗り潰し)。 また、各マスクの意味は、図3.5 に示すデバイス加工手順に従って説明する。なお、設計につい ての詳細は、付録の高電子移動度トランジスタの製作工程にて詳しく記載する。 MESA ORMIC PAD GATE 拡大図
(a)MESA (b) ORMIC (a)GATE (b) PAD 図3.4 HEMT 作成に用いるマスクレイアウト 図3.5 の上図は加工前のエピウエハ断面図、下部は HEMT 形成後のエピウエハ断面図である。 プラズモン共鳴を励起するにあたって、高い共鳴強度を得るためには、前章に述べたようにInP 系材料(InAlAs/InGaAs/InAlAs)を用いる。二次元電子プラズモンは、バリア層 InAlAs とチャ ネル層InGaAs の界面に形成されるが、図中のチャネル層にてグラデーションで示す。A 断面は ゲート幅方向の断面図、B 断面はソース・ドレイン方向の断面図である。なお、図中には加工に 使用したマスク名を下線付きで示す。それぞれ図3.4 に示したマスクレイアウトに対応する。
S.I. substrate S.I. substrate S.I. substrate S.I. substrate バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs A断面(ゲート方向) B断面(ドレイン‐ソース方向) A断面(ゲート方向) B断面 (ドレイン‐ソース方向)
加工
①MESAによる素子間分離 ②ORMICによる ソース・ドレイン電極形成 ③GATEによるゲート電極形成 ③GATEによる キャップ層除去 ④PADによる引き出し電極形成 S.I. substrate S.I. substrate S.I. substrate S.I. substrate バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs バッファ層: i-InAlAs チャネル層: i-In0.53Ga0.47As バリア層: i-InAlAs キャップ層: n-InAlAs+n-InGaAs A断面(ゲート方向) B断面(ドレイン‐ソース方向) A断面(ゲート方向) B断面 (ドレイン‐ソース方向)加工
①MESAによる素子間分離 ②ORMICによる ソース・ドレイン電極形成 ③GATEによるゲート電極形成 ③GATEによる キャップ層除去 ④PADによる引き出し電極形成 図3.5 デバイス加工手順 デバイスの試作工程を以下に示す。工程番号は図3.5 内の丸数字に対応する。 ① 一枚のウエハ上に多くのデバイスを作成するために各デバイスの素子間分離を行う必要が ある。MESA マスクを用いて、デバイス間の電気的導通部分(キャップ層:n-InGaAs/InAlAs、 バリア層:InAlAs、チャネル層:InGaAs)をエッチング除去する。 ② ORMIC マスクを用いて、ソース・ドレイン電極を作成する部分のみに Ti/Au 金属を蒸着し、 リフトオフすることで形成する。 ③ ゲート電極をGATE のパターンデータにより電子ビーム描画する。描画後、キャップ層によ る電気的導通を防ぐため、ゲート電極周りのキャップ層に対してリセスエッチングを行う。その 後、ゲート電極をTi/Au 金属を蒸着し、リフトオフすることで形成する。④ PAD マスクを用いて、プローブコンタクト部までの伝送線を Ti/Au 金属を蒸着、リフトオ フすることで形成する。 以上がHEMT の試作工程となる。電極金属を形成する際には、リフトオフプロセスが必要と なる。リフトオフプロセスを導入しない場合とした場合に分けて、電極金属の形成の違いを図3.6 に示す。図3.6(a)に示すように、リフトオフプロセスを導入しないと、電極金属はレジストの 側面に付き、バリを形成することになる。レジスト除去後、このバリが倒れこむことにより、電 気的誤作動を引き起こす可能性がある。一方、図3.6(a)にリフトオフプロセスを導入した場合 を示す。図に示すようにレジストを二層形成し、上層レジストは設計パターンと同様の大きさで 削り、下層レジストは設計パターンよりも広がりを持つように削る。これを下層レジストの広が りをアンダーカットと呼ぶ。これより、電極金属はレジスト側面に接触することなく形成するこ とができる。よって、バリによる誤動作を防ぐことができる。 レジスト
金属
バリ レジスト金属
バリ (a)一層レジスト二層
レジスト
上層 レジスト 下層 レジスト金属
二層
レジスト
上層 レジスト 下層 レジスト金属
(b)二層レジスト 図3.6 リフトオフプロセス3.2 高電子移動度トランジスタの試作
図3.7 に試作したデバイスの写真を示す。図 3.7(a)には DC 用 HEMT、RF 用 HEMT を示 す。図3.7(b)には RF 用 HEMT の三端子を拡大したものを示す。マスク、描画パターンに対 応して作成されていることが分かる。
図3.7 試作 HEMT
試作したHEMT の層構造を図 4.1 に示す。InP 系材料(InAlAs/InGaAs/InAlAs)を用いてい る。バリア層の上にはキャップ層を設け、オーミック接触によるコンタクト抵抗の軽減を図って いる。オーミック電極としてはアロイ電極が知られているが、耐熱性・信頼性の観点からはノン アロイ電極が好ましい。しかし、HEMT では電極とチャネル層の間にあるバリア層がコンタク ト抵抗の大きな要因となってしまう。そこで、この問題を解決するために、多層キャップ層構造 が報告されている。本デバイスのキャップ層は、コンタクト抵抗分を大きく減少するために InGaAs/InAlAs の二層となっている。キャップ層の違いによるオーミック抵抗の減少について、 図3.9 を用いて説明する。図 3.9(a)に二層キャップ層構造、図 3.9(b)には単層キャップ層の エネルギーバンド図を示す。単層キャップ層を用いると、バリア層による広範囲のポテンシャル 障壁が存在するためにコンタクト抵抗が大きくなってしまう。一方、二層キャップ層構造を用い ることで、ポテンシャル形状はn-InAlAs のキャップ層中で急峻に変化する。これより、電極- チャネル層間の電子のトンネル確率は増大するため、コンタクト抵抗は低下することになる。
S.I. substrate Drain Source Gate
チャネル層: i-In
0.53Ga
0.47As 15nm
バッファ層: i-InAlAs
400nm
バリア層: i-InAlAs
Etch stop i-InP
15nm Planar doping 2nm
キャップ層
i-InGaAs
10nm
i-InAlAs
15nm
Ti/Au
S.I. substrate Drain Source Gateチャネル層: i-In
0.53Ga
0.47As 15nm
バッファ層: i-InAlAs
400nm
バリア層: i-InAlAs
Etch stop i-InP
15nm Planar doping 2nm
キャップ層
i-InGaAs
10nm
i-InAlAs
15nm
Ti/Au
図3.8 試作 HEMT 層構造 (a)InGaAs/InAlAs 二層キャップ層 (a)InGaAs 単層キャップ層 図3.9 キャップ層によるコンタクト抵抗の変化なお、試作において、蒸着時に二層レジストの形状が変化するという問題が生じた。図3.8 に それを示す。図3.8(a)がゲート電極金属を蒸着する前、図 3.8(b)が蒸着後の電子顕微鏡(SEM) 写真である。下層レジストはSF8 を、上層レジストは ZEP520A-7 を使用しており、本研究の条 件ではSF8 は約 6000Å、ZEP520A-7 は約 2000Åとなる。図より、蒸着後はアンダーカット上 の上層レジストZEP520A-7 が反り返っていることが分かる。蒸着装置では装置内部を真空にし た後、電子ビームを照射することで金属を融解する。融解された金属は気体状となり、ウエハに 成膜されていく。その際、高い出力を持って金属を融解すると、蒸着装置内の温度が上昇する。 その熱によって、上層レジストが反り返ってしまったと考えられる。これより、試作したゲート の長さは、本来の設計値にアンダーカット分の長さを加えた長さとなり、設計値よりも大きい値 と取る結果となった。なお、各レジストの詳細は付録の高移動度トランジスタの製作工程にて記 す。 この問題の解決法としては、上層のレジストを厚くすること、耐熱性が優れたレジストを上層 に使用すること、また、三層レジストによるT 型ゲートの作成等が挙げられる。三層レジストは 図 3.10 に示す構造となる。上層はゲートパターンよりも大きく削り、中層はさらに削ることで アンダーカットを形成する。そして下層はゲートパターンの大きさで削り、ゲート電極を形成す る。形成されたゲート電極はT 型のようになるため、このゲートを T 型ゲートと呼ぶ。この構造 を用いることで、ゲート金属の半導体表面に対する実地長はアンダーカットの影響を受けない。 よって今回の問題は解決することができると考えられる。また、三層レジストは微細ゲートを作 成するのにも適している。 (a)二層レジスト蒸着前 (b)二層レジスト蒸着後 図3.10 蒸着における問題
下層レジ スト
金属
中層レジ スト 上層レジ ストT型ゲート
下層レジ スト金属
中層レジ スト 上層レジ ストT型ゲート
図3.9 三層レジストによるゲート作成 3.3 高電子移動度トランジスタの評価 試作したHEMT について、トランジスタとしての基本特性を評価する。前節に示したように、 電極蒸着中に生じる問題によって、ゲート電極が設計値とは異なる値となった。表 3.1 に試作 HEMT のゲート長を示す。試作した HEMT のゲート長は、本来の設計値にアンダーカット分の 長さを足し合わせた、およそ0.97μm~1.4μm の値となった。 図3.10 に 0.97μm ゲートを持つ HEMT の直流電流電圧特性を示す。縦軸は直流ドレイン・ソ ース間電流 Ids、横軸は直流ドレインバイアスVdsである。各グラフ内では、ゲートバイアス Vg をパラメータとし、0.2V 毎にプロットしている。更に、四水準設けたゲート幅Wgをパラメータ として、奥行き方向に並べている。グラフより、通常のトランジスタ動作をしていることが確認 できる。また、ゲート幅Wgに比例するようにドレイン電流量が変化していることが分かる。 図 3.11 にVds=1V 条件における直流Vds-Ids特性を示す。破線は、特性曲線中の線形増加部 分を延長したものである。この破線とグラフ横軸(Ids=0A ライン)の交点から本デバイスの閾値 を見積もると、-0.8V 程度となっていることが分かる。各デバイスでこれと近い値となる。 表3.1 試作 HEMT のゲート長 ゲート長設計値〔μm〕 ゲート長実寸〔μm〕 0.10 0.97 0.15 1.10 0.20 1.40 0.25 1.40 ※ ゲート幅はそれぞれのゲートに対して 10,15,20,50〔μm〕となっている図3.10 直流Vds-Ids特性(Lg = 0.97μm)
ゲート長0.97μm、ゲート幅 10μm の HEMT を用いて、ドレイン電圧Vgs-相互コンダクタン スgm特性を図3.12 に示す。今回の測定では Vdsは飽和領域となる 1.5V に設定している。結果 として、Vgsが-0.4V の時に相互コンダクタンスgmは最大値0.8mS/mm を示した。これにより、 Ids制御ができていると定量的に説明することができる。 次に電流利得特性を図 3.13 に示す。横軸を周波数、縦軸を電流利得としている。電流利得遮 断周波数fTを決定するパラメータ遅延時間τは、ゲート容量Cとgmより、
(
)
m gg
L
L
C
+
Δ
≈
τ
(3.1) と表すことができる。ここで、ΔLは空乏層の広がり等によって生じた実ゲートと実効ゲートの 差である。この式と(2.5)式より、fT は、次のように表すことができる。(
L
L
)
C
g
f
g m T≈
π
+
Δ
2
(3.1) これより、fT は実効ゲート長、ゲート容量と相互コンダクタンスに依存することが分かる。本デ バイスの最も高い動作速度を測定するため、gmが最も高くなる Vgs =-0.4V にて電流利得特性 を測定することにした。また、他のゲート長のデバイスにおいても同様である。なお、Vdsは1.5V に設定している。結果として、fT はゲート長が最も短いデバイスでは32GHz となった。ゲート 長が短くなるに従い、fTは向上することが確認された。 図3.12 Vgs-gm特性(Lg = 0.9μm,Wg = 10μm)図3.13 電流利得-周波数特性(Wg = 10μm) 次章でHEMT からのテラヘルツ電磁波放射について議論するが、本研究にて試作した HEMT の最短ゲート長は0.9μm となった。第二章にて述べたように、テラヘルツ帯電磁波を放射するに は0.5μm 以下のゲート長を持つ InP-HEMT でないと、有意な電磁波放射は得ることはできない。 よって、テラヘルツ帯電磁波放射の実験はすでに試作されている短ゲートInP-HEMT を用いる ことにする。
第
4 章
高電子移動度トランジスタのテラヘルツ帯電磁波放射特性
本章では、二次元電子プラズモン共鳴動作を可能とするテラヘルツ帯高電子移動度トランジス タの基本特性評価、テラヘルツ帯電磁波放射機構の説明、またテラヘルツ帯電磁波の直接観測実 験を行った結果を示し、最後にテラヘルツ帯デバイスとしての考察を行う。本章では、NTT 研 究所で試作された極短ゲートを有するInP-HEMT を用いてテラヘルツ帯電磁波放射の観測実験 を行うことにする。 4.1 テラヘルツ帯高電子移動度トランジスタの評価 二章でも述べたように、サブミクロンゲートを有するHEMT に対して、二次元電子プラズモ ン共鳴現象を用いるとテラヘルツ帯動作が可能となる。試作素子は図らずもゲート長が長くなっ てしまったので、テラヘルツ動作には適さないことが明白となった。そこで、観測実験用として NTT 研究所の提供によるサブ 100nm ゲートの InP 系 HEMT を用いることとした。そのデバイ ス構造を図4.1 に示す。基本的には前章で示した構造を踏襲している。これにより、ゲート長は 30、50、80nm の極短ゲートが形成されている。このゲート長の InP-HEMT ならば、二次元プ ラズモン共鳴周波数はテラヘルツ帯に到達、またその共鳴強度も十分となり、有意なテラヘルツ 帯電磁波の放射が期待される。本章では、その三つのサンプルを用いて検討を行う。なお、ゲー ト幅は50μm となっている。これらのサンプルの基本特性として、図 4.2 に直流ドレイン電流電 圧特性を示す。各デバイスにおいてトランジスタ動作が確認することができる。なお、閾値は各 デバイス共に0V 程度である。また、図 4.3 に後に行うプラズモン共鳴動作と比較のために、電 子走行型デバイスとして機能させた場合の動作領域、fTを示す。ゲート長が30 μm、50 μm、80 μm のfTはそれぞれ230GHz、300GHz、330GHz 程度となった。 図4.1 テラヘルツ電磁波放射検討用 HEMT図4.2 直流Vds-Ids特性
4.2 テラヘルツ帯高電子移動度トランジスタのテラヘルツ帯電磁波放射機構 HEMT デバイスからのテラヘルツ帯電磁波放射機構について、図 4.4 を用いて以下に説明する。 図中における丸数字が電磁波放射までの順序となる。 ① ゲート電極にバイアスを与えることで、ゲート直下を高電子濃度(二次元電子プラズマ状態) する。この状態で、ソース・ドレイン間には直流バイアスを与えることで、定常的なドリフト 走行による電子の流れが生じる。 ② 定常的なドリフト走行による電子の流れが存在している条件下では、境界領域での不連続性 により、プラズマ波が反射される。ここで共振器(実効ゲート長)による定在波条件が満足さ れると、反射波と進行波の重畳により共鳴状態、つまりプラズモン共鳴が励起される。なお、 このプラズモン共鳴は縦波の非放射モードである。 ③ プラズモン共鳴による分極振動がチャネル層内、また近傍に配置された各電極に伝わる。 ④ 分極振動により電磁場が生成、つまりプラズモン共鳴の非放射モードが放射モードに変換さ れる。この放射される電磁波は、プラズモン共鳴周波数と同様でテラヘルツ波が放射されるこ とになる。 以上がHEMT の電磁波放射機構となる。なお、上記の他にも、二次元電子プラズモン共鳴に 加えて、特定のバイアス条件においてはプラズマ不安定性も生じる。 4.4 HEMT の電磁波放射機構
4.3 テラヘルツ電磁波放射の実験 4.3.1 実験系 テラヘルツ電磁波放射の観測には、フーリエ赤外分光法:FTIR を用いた。FTIR の概略図を 図4.5 に示す。HEMT デバイスを設置し、ゲートバイアス、ドレインバイアスを印加する。それ により放射されたテラヘルツ電磁波は、始めにマイケルソン干渉計により分光される。このマイ ケルソン干渉計は、図に示すように固定ミラーと移動ミラーが配置されており、入射したテラヘ ルツ波はハーフミラーにより分けられる。反射したテラヘルツ波は固定ミラーで反射して出射、 透過したテラヘルツ波は移動ミラーで反射した後に出射する。これらの二つの異なる光路を持っ たテラヘルツ波は出斜口で混合して干渉を起こす。二つの光路長の差が波長の整数倍の場合には 強め合い、整数プラス1/2 波長の場合には弱め合う。稼動ミラーを動かすことで、テラヘルツ波 の強度は稼動ミラーの位置の関数となり、サインカーブの干渉パターンとなる。そして、この干 渉したテラヘルツ波をSi ボロメータで検知し、干渉パターンを FFT で変換するとスペクトルと なり、周波数特性を得ることができる。なお、テラヘルツ波は大気に吸収されやすいという特殊 な性質を持つため、図において破線で囲った部分、つまりHEMT デバイスから Si ボロメータの 入り口までを真空容器内に収めている。
HEMT device
Drain
Source
Gate
Voltage
Source
Voltage
Source
Drain
Gate
Source
PC
Si
Bolometer
Vacuum Area
Fixed mirror
Moving mirror
Terahertz
emission
Michelson
interferometer
HEMT device
Drain
Source
Gate
Voltage
Source
Voltage
Source
Drain
Gate
Source
PC
Si
Bolometer
Si
Bolometer
Vacuum Area
Fixed mirror
Moving mirror
Terahertz
emission
Michelson
interferometer
図4.5 フーリエ赤外分光計測:FTIRSi ボロメータは入り口にフィルタをかけ、特定の範囲の信号を検知する。本実験で使用する Si ボロメータのフィルタ特性を図 4.6 に示す。三つのフィルタを搭載しており、フィルタ1は 0.5~8THz 程度と広帯域であり、フィルタ2、フィルタ3はフィルタ1とは比較して帯域は狭く なる。本実験では、フィルタ1を用いることにする。 図4.6 Si ボロメータフィルタ特性 HEMT デバイスを測定機器と接続するには専用のプローバーが必要となるが、真空容器内に プローバーを設置するのは困難である。そこで、HEMT をパッケージに実装し、そのパッケー ジと外部の測定機器と接続した。本実験で用いた HEMT の写真とパッケージの実装図を図 4.7 に示す。HEMT の形状は、前章で試作したものと同様で RF 用 HEMT となる。HEMT の三端 子とパッケージを接続するには、Φ25μm の金線を使用して、ワイヤーボンディングを行った。 図4.7 中の右にワイヤーボンディングの例を示す。内装された端子と外装された端子は導通して おり、導通している端子をアルファベットによって示す。図中では、ソース、ゲート、ドレイン をそれぞれ端子E、F、G へと接続している。次にパッケージを図 4.8 に示すように、ホルダー にセットすることで測定機器に接続することが可能となる。 図4.9 に実験系の概観を示す。
図4.6 デバイス写真とパッケージへの HEMT 実装図
図4.8 パッケージと測定機器の接続用ホルダー
4.9 実験系の概観
4.3.2 測定結果 はじめに、室温条件下でInP-HEMT を用いて、初めてテラヘルツ波放射の観測に成功したこ とを報告する。測定条件は二章で示したDyakonov モデルと同様、ゲート端とドレイン端には直 流バイアスを与え、ソース端は接地している。図4.9、図 4.10 に InP-HEMT からのテラヘルツ 波放射特性の結果を示す。 図4.9 テラヘルツ波放射特性(Vds依存性) 図4.10 テラヘルツ波放射特性(Lg依存性) 図4.9 は横軸をソース-ドレイン間電圧Vds、縦軸を放射テラヘルツ波の強度としている。測定 に用いた試料はゲート長が30nm の HEMT である。ゲート-ソース間電圧Vgsは0.4V に設定し ている。周波数特性の結果は、1~7THzのブロードでモノピークなテラヘルツ波放射が得ら れた。理論的にはプラズモン共鳴周波数は(2.29)式、また Q 値を(2.27)式で表すことができ、特 HEMT
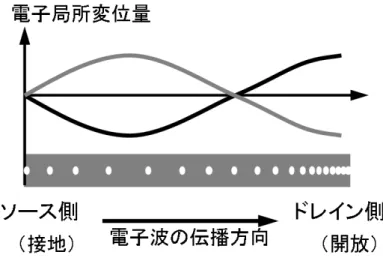
![図 2.9 : 基本共鳴周波数、Q 値のチャネル長依存性 [4]](https://thumb-ap.123doks.com/thumbv2/123deta/5898119.1049013/20.892.223.674.203.938/図29基本共鳴周波数Q値のチャネル長依存性4.webp)